
이미지 센서 적용을 위한 In0.7Ga0.3As QW HEMT 소자의 extrinsic trans-conductance에 영향을 미치는 성분들의 포괄적 연구
This is an Open Access article distributed under the terms of the Creative Commons Attribution Non-Commercial License(https://creativecommons.org/licenses/by-nc/3.0/) which permits unrestricted non-commercial use, distribution, and reproduction in any medium, provided the original work is properly cited.
Abstract
The components affecting the extrinsic transconductance (gm_ext) in In0.7Ga0.3As quantum-well (QW) high-electron-mobility transistors (HEMTs) on an InP substrate were investigated. First, comprehensive modeling, which only requires physical parameters, was used to explain both the intrinsic transconductance (gm_int) and the gm_ext of the devices. Two types of In0.7Ga0.3As QW HEMT were fabricated with gate lengths ranging from 10 μm to sub-100 nm. These measured results were correlated with the modeling to describe the device behavior using analytical expressions. To study the effects of the components affecting gm_int, the proposed approach was extended to projection by changing the values of physical parameters, such as series resistances (RS and RD), apparent mobility (μn_app), and saturation velocity (vsat).
Keywords:
Image sensor, Trans-conductance(gm), HEMTs, InGaAs, High-mobility and device modeling1. 서 론
In-rich 채널 InxGa1-xAs/In0.52Al0.48As (x > 0.53) 물질을 이용한 HEMT 소자들은 반도체 표면의 전하량 변화에 매우 민감한 전류 변화를 나타내므로, 이를 이용하여 초소형, 저전력 및 초고주파에 대응 가능한 고민감도의 센서 제작이 가능하며, 통신 시스템 그리고 이미지 센서 등 다양한 분야에서 응용되고 있다 [1-4]. 근래 차단 주파수(fT)가 738 GHz인 InP HEMT 소자 [5]가 발표된 바 있으며, 최대 공진 주파수(fmax)가 1 THz 인 소자가 보고되었다 [6].
HEMT 기반의 고민감도 센서 제작을 위해서는 우수한 동작특성을 구현하는 것이 필수적인 요소이다. 소자의 성능 지표인 fT, fmax에는 외부에 인가되는 전압에 따른 소자의 실질적인 드레인 전류 증폭 특성인 gm_ext가 직접적으로 관여하고 있다는 사실이 여러 연구 [7-9]를 통해 알려져 있다. gm_ext는 전자 수송 특성의 개선, 기생 저항의 감소 [10] 및 output-conductance(go)를 줄이는 것을 통하여 향상 시킬 수 있음이 알려져 있다. 특히, Lg가 작을수록 FET의 gm_ext가 개선되는 경향성을 보여주었으며, 이는 곧 고주파수 특성의 향상으로 이어졌기에 오랫동안 Lg를 감소시키는 방향으로 연구가 진행되었다. 그러나, 최근 보고된 FET 소자들의 전자 수송은 이미 ballistic 영역에 진입하였으며[12,13], 단순히Lg를 줄이는 것 만으로 gm_ext를 개선시키기는 어려워졌다.
본 연구에서는 gm_ext를 물리적인 parameter를 활용하여 구현한 해석적인 모델링을 제시하며, 모델링의 유효성을 평가하기 위해 i-line 스테퍼(stepper) 및 전자빔 노광 (e-beam lithography)기술을 적용한 2가지 종류의 In0.7Ga0.3As QW HEMT 소자를 제작하였다. 그리고 제작된 소자들의 DC 측정 결과를 통해 얻은 gm_ext 값들을 해석적 모델링과 결부시키는 것으로, 다양한 범위의 Lg 에 대한gm_ext를 포괄적으로 설명할 수 있는 물리적 parameter들의 값을 제시하였다. 마지막으로, 모델링의 성분들을 변화시키며 기생 저항과 전자 수송 특성과 같은 요인들이gm_ext에 어떤 영향을 미치는 지 논리적으로 분석하였다.
2. 연구 방법
2.1 포화 영역 gm_ext 및 gm_int의 해석적 모델링
외부 전압인가단에 값의 변화에 따라 결정되는 값인 gm_ext 및 소자의 내부 캐리어 수송 특성에 의해서 결정되는 gm_int 사이의 관계는 수식 (1)과 같이 주어지게 된다 [10].
| (1) |
Fig. 1 과 같이, gm_int 은 직렬 연결된 기생 저항 성분인 RS 및 RD 그리고 DIBL과 같은 요인으로 인한 output-conductance(go) 에 의해 감소하여 gm_ext으로 표현된다. 이 때, go 는 Lg 감소에 따라 증가하는 값이므로, 단채널에서 gm_ext의 감소폭이 커지게 되며 이는 각 소자들의DC 특성을 통해 확인 가능하다. 또한, 포화 영역에서의 gm_int은 소자의 FET의 캐리어 수송 특성을 반영한 포화 영역 드레인 전류 수식 (2)을 VGSi에 대해 미분하는 것으로 수식 (3)과 같이 표현할 수 있다.
| (2) |
| (3) |
| (4) |
VGSi의 변화에 따른 VDSi_sat의 변화량을 수식 (4)와 같이 물리적인 parameter로 나타낼 수 있으며, 이를 수식 (3)에 대입하면 아래와 같다.
| (5) |
이 때, 위 수식은 단위 면적당 intrinsic gate capacitance (Cgi), 반전층의 전계에 의해 결정되는 유효 이동도(apparent mobility, μn_app) 그리고 saturation velocity (vsat)와 같은 물리적인 parameter로 구성되어 있다. 위 식과 식 (1)을 연관 짓는 것으로 FET소자의 gm_ext 값을 물리적 parameter의 조합을 통해 표현할 수 있으며, 그 결과가 다양한 범위의 Lg에 대해 In0.7Ga0.3As QW HEMT에서 어떻게 나타나는지는 다음 장에서 살펴 볼 예정이다.
2.2 에피 구조 및 소자 공정
In0.7Ga0.3As QW HEMT 제작을 위한 에피층은 반절연 성질의 InP 기판에 분자빔 에피택시 (MBE) 방식을 이용하여 성장 되었다. 에피층은 10 nm 두께 n+ In0.7Ga0.3As (Si 도핑, 5 × 1019cm-3)와 30 nm 두께 n+ In0.53Ga0.47As (Si 도핑, 5 × 1019 cm-3)로 구성된 Capping layer 아래에 4-nm 두께 진성 InP etch stopper, 8-nm 두께의 진성 In0.52Al0.48As barrier 영역 및 5 × 1019 cm-3의 Si 델타 도핑 영역, 3-nm 두께 진성 In0.52Al0.48As spacer 영역, 10-nm 두께 진성 In0.7Ga0.3As 채널 영역 및 300-nm 두께 진성 In0.52Al0.48As 완충층으로 구성된다.
게이트 길이에 따라 Fig. 2와 같이 2가지 형태로 제작되었으며, 3-인치 InP 기판에서 i-line stepper를 통해 제작하였다. Fig. 2(a) 구조의 장채널 소자는 i-line stepper를 통해 게이트를 형성하였으며, 그 길이는 10 μm에서부터 0.5 μm까지의 범위로 제작하였다. Fig. 2(b) 구조의 단채널 소자는 전자빔 노광 기술을 이용하여 연구실에서 기 발표된 논문과 동일한 방식으로 게이트를 형성하였으며 [12], 게이트 길이는 300 nm 부터 30 nm 이하까지 범위로 제작하였다.
다음 절에서는 제안된 모델링 및 제작된 HEMT의 DC 측정 결과와의 결부를 통해 모델링의 검증 및gm_ext에 영향을 미치는 요인들에 대한 분석하고자 한다.
3. 결과 및 고찰
3.1 In0.7Ga0.3As QW HEMT의 DC 특성 및 해석적 모델링
Fig. 3(a)는 제작된 2가지 종류의 In0.7Ga0.3As QW HEMT의 포화 영역인VDS = 0.8 V에서 측정된 gm_ext 값을 gate overdrive voltage(VGS – VT)에 따라 다양한 게이트 길이에 대해 나타낸 결과이다.
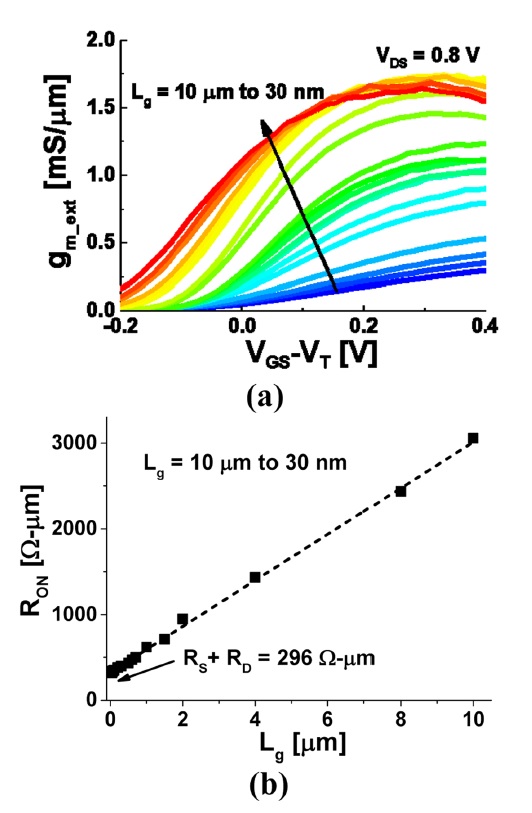
(a) gm_ext characteristics at VDS = 0.8 V, for the fabricated devices with Lg from 10 mm to 20 nm, and (b) the measured on-resistance (RON) against Lg values of the fabricated devices.
장채널 소자에서는 전류값에 관여하는 반전층 전계의 크기가 Lg에 반비례 하며 이에 따라 gm_ext 값이 gate overdrive voltage와 Lg에 비례 하는 것을 확인할 수 있다. 또한, 단채널 소자에서는 전계의 크기가 Lg와 무관하게 포화되므로 gm_ext 값 또한 포화되는 특성이 관찰된다 [11]. Fig. 3(b)는 제작된 소자들의 Lg길이에 따른 온 저항 (On resistance, 이하 RON) 특성을 보여주고 있으며, RON은 게이트 아래 저항인 채널 저항(Rch)및 소스와 드레인 저항의 합(RS와 RD)으로 이루어진다. 이 때 Rch는 Lg에 비례하므로, 해당 그림의 y 절편이 RS와 RD 의 합이 된다. 제시한 방법으로 추출한 RS의 값은 148 Ω·μm이다.
Fig. 4 는 VDS = 0.8 V, VGS – VT = 0.36 V 일 때 10 μm에서 30 nm까지 범위에서 측정된 gm_ext 값을 나타낸 다음, 식 (1)을 통해 gm_int 값을 추출하였다. 식(5)의 Cgi 값은 소자 구조에 의해 결정되는 parameter이며 고정된 값을 사용하였다. 이 때 사용한 물리적 parameter 들은 각각 RS = 148 Ω·μm, Cgi = 0.66 mF/cm2, μn_app = 11,000 cm2/Vs, vsat = 4.7 × 107 cm/s 이다. 그 결과, 소자들의 전자 수송 특성을 반영하는 gm_int 및 실제 소자의 특성을 나타내는 gm_ext 의 모델링 결과가 측정된 값을 모든 영역의 Lg에 대해 잘 설명하고 있으며, 본 모델링을 통하여 gm_ext에 영향을 미치는 요인들에 대한 분석을 하고자 한다.
3.2 기생 저항 및 전자 수송 특성 변화에 따른 gm_ext 변화 분석
Fig. 5(a)는 모델링의 물리적 parameter 중에서 기생 저항 성분을 148 Ω·μm에서 각각 250 Ω·μm 및 50 Ω·μm 으로 변화시킨 결과를 보여준다. Ballistic 수송이 발생하는 Sub-50 nm 영역부터 mobility에 의한 수송이 일어나는 장채널 영역까지 모두 RS값이 감소할수록 gm_ext이 증가하는 경향을 확인하였다.
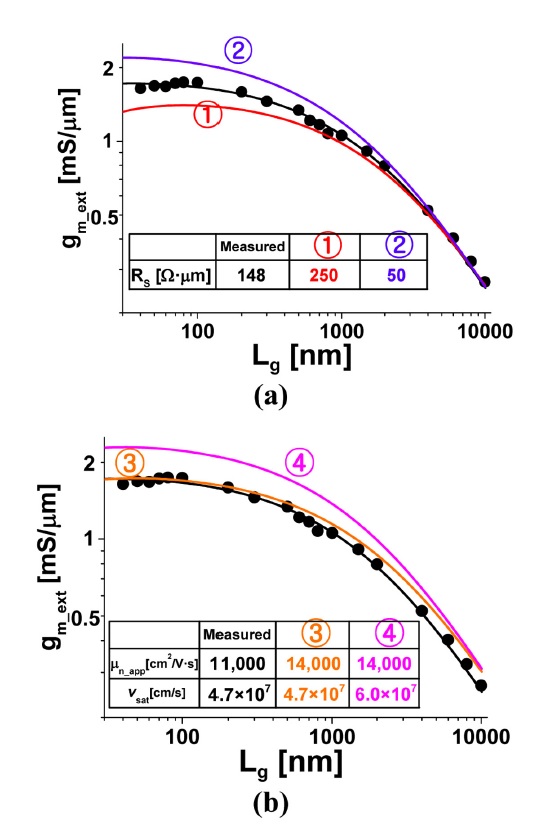
Measured and modeled gm_ext, together with the model projection while changing (a) ① RS = 250 Ω·μm, ② RS = 50 Ω·μm, (b) ③ μn_app = 14,000 cm2/V·s and vsat = 4.7 × 107 cm/s as well as ④ μn_app = 14,000 cm2/V·s and vsat = 6.0 × 107 cm/s.
특히 단채널 영역에서는 증가하는 폭이 상대적으로 큰 것을 확인할 수 있다. 또한 Fig. 5(b)는 μn_app 의 값을 11,000 cm2/Vs에서 14,000 cm2/Vs 으로 바꾼 경우 및 그와 동시에 vsat 값까지 4.7 × 107 cm/s 에서 6.0 × 107 cm/s 로 변화시킨 결과를 나타내고 있다. 이 때, μn_app 값이 증가함에 따라 장채널 영역의 gm_ext이 증대되며, vsat 값은 단채널 영역에서 그 영향력을 행사하는 것을 확인할 수 있다. Fig. 5를 통하여 기생 저항 성분을 감소시키는 것과 동시에 전자 수송 특성인 μn_app 및vsat 를 균형 잡힌 방향으로 발전시켜 gm_ext값을 극대화 할 수 있음을 의미한다.
4. 결 론
다양한 범위의 Lg를 갖는 In0.7Ga0.3As QW HEMT 에 대하여 물리적 parameter인 Cgi, μn_app, vsat 로 구성된 해석적인 gm_ext 모델링이 제안되었다. 2 가지 방법으로 제작된 In0.7Ga0.3As QW HEMT의 측정된 gm_ext를 제안된 모델링을 통해 해석하고자 했으며, 이후 기생 저항과 전자 수송 특성의 변화에 따른 gm_ext 변화 양상을 분석하였다. 기생 저항 성분이 감소에 따라 gm_ext가 개선되었으며, 특히 채널의 길이가 짧아질수록 그러한 경향이 분명해졌다. 또한, μn_app의 변화는 장채널 영역, vsat의 경우는 단채널 영역의 gm_ext에 영향을 주었다. 이는 HEMT 소자의 gm_ext성능, 더 나아가 초고주파 특성 개선을 위해 기생 저항의 감소 및 전자 수송 특성의 최적화 과정이 매우 중요하다는 사실을 시사한다.
Acknowledgments
본 연구는 방위사업청 및 산업통상자원부의 공동재원으로 민군겸용기술개발사업 (No. 19-CM-BD-05)의 지원으로 수행된 결과임.
REFERENCES
-
T. Takahashi, M. Sato, K. Makiyama, T. Hirose, and N. Hara, “InAlAs/InGaAs HEMTs with minimum noise figure of 1.0 dB at 94 GHz”, Proc. IEEE 19th Int. Conf. IPRM, pp. 55-58, Matsue, Japan, 2007.
[https://doi.org/10.1109/ICIPRM.2007.381121]

-
K. M. H. Leong, X. Mei, W. H. Yoshida, A. Zamora, J. G. Padilla, B. S. Gorospe, K. Nguyen, and W. R. Deal, “850 GHz receiver and transmitter front-end using InP HEMT”, IEEE Trans. THz Sci. Technol., Vol. 7, No. 4, pp. 466-475, 2017.
[https://doi.org/10.1109/TTHZ.2017.2710632]

-
W. R. Deal, K. Leong, A. Zamora, B. Gorospe, K. Nguyen, and X. B. Mei, “A 660 GHz up-converter for THz communications”, Proc. IEEE Compd Semicond. Integr. Circuit Symp. (CSICS), pp. 1-4, Miami, FL, USA, 2017.
[https://doi.org/10.1109/CSICS.2017.8240460]

-
A. Tessmann, A. Leuther, S. Wagner, H. Massler, M. Kuri, H. -P. Stulz, M. Zink, M. Riessle and T. Merkle, “A 300 GHz low-noise amplifier S-MMIC for use in next-generation imaging and communication applications”, Proc. IEEE MTT-S Int. Microw. Symp., pp. 760-763, Honololu, Hi, USA, 2017.
[https://doi.org/10.1109/MWSYM.2017.8058687]

- H. B. Jo, S. W. Yun, J. G. Kim, D. Y. Yun, I. G. Lee, D. H. Kim, T. W. Kim, S. K. Kim, J. Yun, T. Kim, T. Tsutsumi, H. Sugiyama, and H. Matsuzaki, “Lg = 19 nm In0.8Ga0.2As composite-channel HEMTs with fT = 738 GHz and fmax = 492 GHz”, 2020 Int. Electron. Devices. Meet., pp. 8.4.1-8.4.4, 2020
-
X. Mei, W. Yoshida, M. Lange, J. Lee, J. Zhou, P. H. Liu, K. Leong, A. Zamora, J. Padilla, S. Sarkozy, R. Lai, and W.-R. Deal, “First Demonstration of Amplification at 1 THz Using 25-nm InP High Electron Mobility Transistor Process”, IEEE Electron. Device. Lett., Vol. 36, No. 4, pp. 327-329, 2015.
[https://doi.org/10.1109/LED.2015.2407193]

-
D. Y. Yun, H. B. Jo, S. W. Son, J. M. Baek, J. H. Lee, T. W. Kim, D. H. Kim, T. Tsutsumi, H. Sugiyama, and H. Matsuzaki, “Impact of the source-to-drain spacing on the DC and RF characteristics of InGaAs/InAlAs high-electron mobility transistors”, IEEE Electron. Device. Lett., Vol. 39, No. 12, pp. 1844-1847, 2018.
[https://doi.org/10.1109/LED.2018.2876709]

-
T. Takahashi, Y. Kawano, K. Makiyama, S. Shiba, M. Sato, Y. Nakasha, and N. Hara, “Enhancement of fmax to 910 GHz by adopting asymmetric gate recess and double-side-doped structure in 75-nm-gate InAlAs/InGaAs HEMTs”, IEEE Trans. Electron. Devices., Vol. 64, No. 1, pp. 89-95, 2017.
[https://doi.org/10.1109/TED.2016.2624899]

-
H. Sugiyama, T. Hoshi, H. Yokoyama, and H. Matsuzaki, “Metal-organic vapor-phase epitaxy growth of InP-based HEMT structures with InGaAs/InAs composite channel”, Int. Conf. on IPRM, pp. 245-248, Santa Barbara, CA, USA, 2012.
[https://doi.org/10.1109/ICIPRM.2012.6403369]

-
S. Y. Chou and D. A. Antoniadis, “Relationship between measured and intrinsic transconductances of FET’s”, IEEE Trans. Electron. Devices., Vol. 34, No. 2, pp 448-450, 1987.
[https://doi.org/10.1109/T-ED.1987.22942]

-
Y. Taur and T. H. Ning, Fundamentals of Modern VLSI Devices, 2nd ed., Cambridge University Press, Chicago, 2009.
[https://doi.org/10.1017/CBO9781139195065]

-
H. B. Jo, S. W. Yun, J. G. Kim, J. M. Baek, I. G. Lee, D. H. Kim, T. W. Kim, S. K. Kim, J. Yun, T. Kim, T. Tsutsumi, H. Sugiyama, and H. Matsuzaki, “Sub-30-nm In0.8Ga0.2As Composite-Channel High-Electron-Mobility Transistors with Record High-Frequency Characteristics” IEEE Trans. Electron. Devices., Vol. 68, No. 4, pp. 2010-2016, 2021.
[https://doi.org/10.1109/TED.2020.3045958]

-
R. Lai, X. B. Mei, S. Sarkozy, W. Yoshida, P. H. Liu, J. Lee, M. Lange, V. Radisic, K. Leong, and W. Deal, “Sub 50 nm InP HEMT with fT = 586 GHz and amplifier circuit gain at 390 GHz for sub-millimeter wave applications”, 2010 22nd Int. Conf. Indium. Phosphide Relat. Mater.(IPRM), pp. 1-3, 2010.
[https://doi.org/10.1109/ICIPRM.2010.5516002]